Spectroscopic Ellipsometer
SE MG-1000
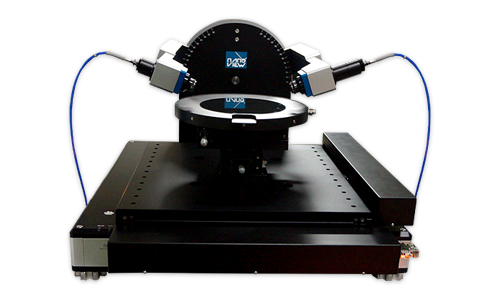

- Spectroscopic data measurement
– Visible range: 350~840 nm (or 1.5~3.5 eV)
– Data acquisition speed: 5 sec for full spectra of {Δ, Ψ} - Manually variable angle of incidence
– 45°~90° with 5° step - Single body system
– 40 cm (W) × 30 cm (D) × 30 cm (H), 15 kg (typical)
* UV- option requires external lamp power supply - Easy operation
– No set-up / No keys to control
– Low maintenance - User-friendly software
– operation and analysis - Other features
– Sample stage with tilt & height adjustments
sample size: (5 mm × 5 mm) ~ (200 mm × 200 mm)
– Computer with current operating software - Options
– Mapping stage: manual or automatic
– UV-option: 250~840 nm (or 1.5~5.0 eV)
SE MF-1000

- Spectroscopic data measurement
– Visible range: 350~840 nm (or 1.5~3.5 eV)
– Data acquisition speed: 5 sec for full spectra of {Δ, Ψ} - Compact size for mobility
– 28 cm (W)× 20 cm (D)× 6 cm (H), 6kg - Easiest operation in the world
– No set-up / No keys to control
– No effort for alignment (sample faces down)
– Maintenance-free (except lamp )
– Calibration free (patented)* - User-friendly software
– operation and analysis - Other features
– Fixed angle of incidence: 70° ± 0.5°
– Sample size: (8 mm × 8 mm) ~ (200 mm × 200 mm)
– Computer with current operating software
Most ellipsometers require calibration process in each measurement to find the
azimuths of optical elements.
This is a lengthy and complicated process.
SE MF-1000 is calibration free. This makes fast and easy measurement.
SE MH-1000

- Spectroscopic Ellipsometer Head Type
– Single head type for mapping large-area sample
– Dimension: 25 cm (W)× 15 cm (D)× 30 cm (H)
– Fixed Incident angle
– Wavelength range: 350 ~850 nm
– Data acquisition speed: 5 sec for full spectra of {Δ, Ψ} - Gantry type Stage for Spectroscopic Ellipsometer Head
– Structure: gantry type (Linear motors): X-Y-Z
– Operation: step & repeat
– Max. speed: 0.5 m/s
– Position accuracy: ±10 mm / full scale
– Repeatability: ±5 mm / full scale
– Flatness: 30± mm / full scale
– Straightness: 15± mm / full scale
– Pay load: 20 kg at X-slide - Easiest operation in the world
– Vibration Isolation Table
– Confocal laser scanning microscope
– Contact angle measurement
– 4-point probe
– etc.
SE MI-1000

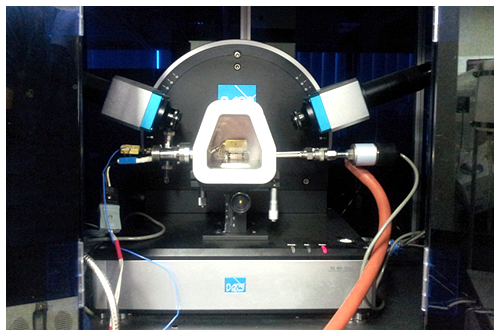
- Spectroscopic Ellipsometer Head Type
– Visible range: 350~840 nm (or 1.5~3.5 eV)
* UV-option: 250~840 nm (or 1.5~5.0 eV)
– Data acquisition speed: <5 sec for full spectra of {Δ, Ψ} - Fixed Incident angle - Assistance for In Situ System Design
– Vacuum system
– Heating cell, chemical cell
– Mechanical system for interfacing IN Situ System and ellipsometer - Option
– Optical windows for chamber or cell
– Mechanical shutters for preventing coating on optical windows
– Computer with current operating software
Customized Ellipsometer
Imaging Ellipsometer

- ~0.1 nm thickness difference can be seen by IE-1000.
- Thickness distribution of thin film can be imaged.
- Thickness and optical images of semiconductor device, display, and bio samples.
- IE-1000 can show the images which can not be seen by conventional microscope.
- Defect of semiconductor and display can be seen directly.
- Easy and fast operation.
Vacuum Ellipsometer

- Spectral range down to VUV ( 145 ~ 320㎚)
- Short nitrogen purge time < 5 mins.
- Table top, small foot print.
- Manually variable angle of incidence: 45°~90°
* Application to 193 nm Immersion Lithography
* Easy & accurate measurement of thickness and refractive index for very thin
films of semiconductor
* ARC, PR, high k , oxide, nitride, pellicle and metal.
Near IR Ellipsometer

Micro-spot Ellipsometer

Etc (Rubbins-1000)
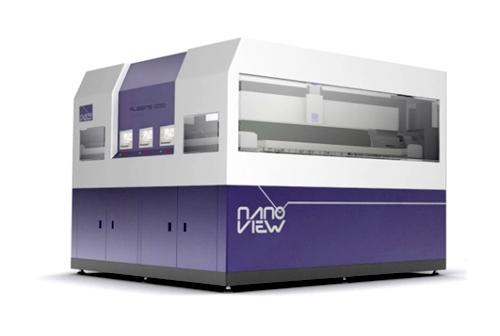
- Rubbing Inspection
– 1-D (& 2-D) rubbing strength distribution can be mapped for whole LCD panel.
– Deviation by measurement positions is less than 10% → Quick sample is possible.
– Signal difference among different rubbing condition is distinctive.
– Underlying important part and/or defect can also be distinctively measured.
– In-line or off-line measurement
– Thickness, refractive index {n, k} and uniformity measurement of any thin film
layer including polyimide layer. (optional) - Mapping Stage (whole glass for any generation)
– Travel: 2280 mm × 1920 mm for 7-G
– Max.speed: 0.5 m/s
– Clean room quality
– Vacuum chuck and booth
* Rubbing Inspection for LCD
* Rubbing Strength Measurement for Process Control
* Optical Axis Measurement in LC Alignment Layer
* Whole Glass without Rotation, Off- & In-Line System
Spectroscopic Reflectometer
SR MR-1000

SR MR-2000
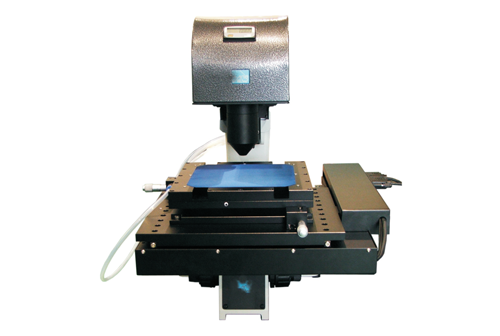
- Application
– Antireflective coating (ARC) on textured (poly-) crystalline silicon solar cell - Measurement
– Thickness, Reflectivity, n&k - Wavelength
– 420 – 950 nm (1.3-3.0 eV) : expandable - Accuracy (thickness measurement on specular sample)
– 104.5 nm for 104.8 nm SiO₂on c-Si
* Accuracy can be dependent on the quality of film - Thickness range
– 10 nm ~ 20 mm (depend on sample) - Data acquisition time
– < 1 s - Beam spot size
– ~ 50 mm - Focusing of beam
– Manual (optional auto-focus) - Sample stage
– Manual X-Y stage (specify sample size and travel distance)
(optional automatic X-Y stage for mapping)

